
发布时间:2021-12-21 阅读:1881
光刻技术是现代科学技术发展的关键驱动力之一,它在集成电路制造、微电子学和微纳米制造中有许多应用。随着科学技术的快速发展,实现一种能够突破现有技术限制的纳米级光刻技术已经是一个不可阻挡的目标。纳米图案的线宽和刻蚀深度是光刻技术的重要指标,这一领域的最终研究目标是获得一种具有窄线宽和足够刻蚀深度的纳米光刻技术。
在本文中,我们提出了一种在对称金属包覆波导(SMCW)中利用超高阶模(UOMs)进行纳米级光刻的方法,在近场中利用SMCW的超高阶导模,在不聚焦的情况下,利用360nm连续光激发该波导,从而实现线宽小于100nm的光刻图案,并且纳米图案的刻蚀深度超过200nm。局域光强分布可以用来绘制光刻胶的曝光图,这与我们的理论模型是一致的。在模式振荡区中,UOMs具有较窄的线宽和较高的功率密度。同时,由于入射角较小,SMCM的有效折射率非常小,说明UOMs的群速度在传输方向上接近于零。耦合光被限制在一个很小的区域内,相干振荡区域内的振荡场得到增强。高能量密度的导模共振线宽可以达到纳米级,使衍射极限被打破。我们在理论和实验上都证实了该方法的可行性,并且可以通过调节波导与光刻胶之间的距离和改变导波层的厚度来控制光刻图案的线宽。这种方法不需要在真空环境或EUV光源下进行,成本低廉且易于实现,为实现无掩膜和低功率可见光光刻提供了可能。
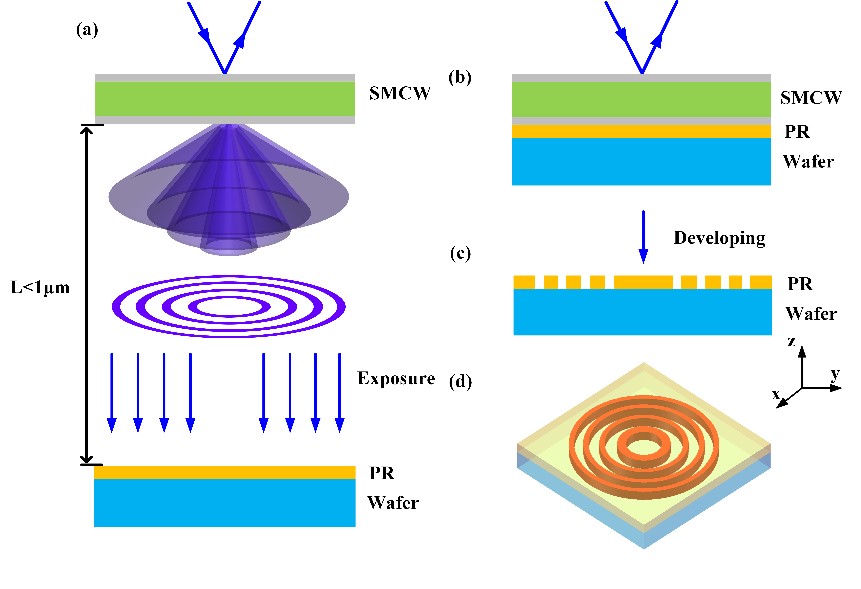
图一 UOM光刻系统原理图 (a)由UOMs泄漏辐射形成的透射光锥;(b)光刻胶经过UOM曝光;(c)显影后,得到光刻图案;(d)光刻图案示意图。
该成果发表在“Meng Zhang, Hailang Dai, Yuxi Shang, Zhuangqi Cao, and Xianfeng Chen, Maskless nanostructure photolithography by ultrahigh-order modes of a symmetrical metal-cladding waveguide, Optics letters, 47, 62-65 (2022)”
原文链接:https://doi.org/10.1364/OL.446431